Summary: In primo luogo, la formazione di composti metallici bersaglio Nel processo di formazione del...
In primo luogo, la formazione di composti metallici bersaglio
Nel processo di formazione del composto dalla superficie del bersaglio metallico attraverso il processo di sputtering reattivo, dove si forma il composto? Poiché le particelle di gas reattivo entrano in collisione con gli atomi sulla superficie bersaglio per generare una reazione chimica per generare atomi composti, solitamente una reazione esotermica, la reazione genera calore. Deve esserci un modo per la conduzione, altrimenti la reazione chimica non può procedere. Il trasferimento di calore tra i gas è impossibile sotto vuoto, quindi le reazioni chimiche devono avvenire su una superficie solida. I prodotti di sputtering reattivo vengono eseguiti su superfici target, superfici di substrato e altre superfici strutturate. Il nostro obiettivo è generare composti sulla superficie del substrato. Generare composti su altre superfici è uno spreco di risorse. La generazione di composti sulla superficie bersaglio era inizialmente una fonte di atomi composti, ma in seguito divenne un ostacolo alla fornitura continua di più atomi composti.
In secondo luogo, i fattori che influenzano l'avvelenamento da bersaglio
Il fattore principale che influenza l'avvelenamento bersaglio è il rapporto tra gas reattivo e gas sputtering. L'eccessivo gas reattivo porterà all'avvelenamento del bersaglio. Durante il processo di spruzzatura reattiva, la regione del canale di spruzzatura sulla superficie target è coperta dal prodotto di reazione del prodotto di reazione viene staccato per riesporre la superficie metallica. Se la velocità di formazione del composto è maggiore della velocità con cui il composto viene rimosso, l'area coperta dal composto aumenta. Nel caso di una certa potenza, la quantità di gas di reazione che partecipa alla formazione del composto aumenta e la velocità di formazione del composto aumenta. Se la quantità di gas reattivo aumenta eccessivamente, l'area coperta dal composto aumenta. Se la portata del gas reattivo non può essere regolata in tempo, la velocità di aumento nell'area coperta dal composto non può essere soppressa e il canale di sputtering sarà ulteriormente coperto dal composto. Quando il bersaglio sputtering è completamente coperto dal composto Quando il bersaglio è completamente avvelenato.
Terzo, il fenomeno dell'avvelenamento da bersaglio
(1) Accumulo di ioni positivi: quando il bersaglio viene avvelenato, sulla superficie del bersaglio si forma una pellicola isolante. Quando gli ioni positivi raggiungono la superficie target del catodo, a causa del blocco dello strato isolante, non possono entrare direttamente nella superficie target del catodo ma si accumulano sulla superficie target, che è soggetta a campo freddo. Scarica dell'arco: colpi d'arco che impediscono il proseguimento dello sputtering.
(2) L'anodo scompare: quando il bersaglio viene avvelenato, una pellicola isolante si deposita anche sulla parete della camera a vuoto collegata a terra e gli elettroni che raggiungono l'anodo non possono entrare nell'anodo, con conseguente scomparsa dell'anodo.
In quarto luogo, la spiegazione fisica dell'avvelenamento da bersaglio
(1) In generale, il coefficiente di emissione di elettroni secondari dei composti metallici è superiore a quello dei metalli. Dopo che il bersaglio è stato avvelenato, la superficie del bersaglio viene ricoperta di composti metallici. Dopo essere stati bombardati da ioni, il numero di elettroni secondari rilasciati aumenta, il che migliora l'efficienza spaziale. Conducibilità, riduzione dell'impedenza del plasma, con conseguente riduzione della tensione di sputtering. Pertanto, il tasso di sputtering è ridotto. In generale, la tensione di sputtering dello sputtering del magnetron è compresa tra 400 V e 600 V. Quando si verifica l'avvelenamento del bersaglio, la tensione di sputtering verrà notevolmente ridotta.
(2) La velocità di sputtering del target metallico e del target composto è diversa. Generalmente, il coefficiente di sputtering del metallo è superiore a quello del composto, quindi il tasso di sputtering è basso dopo che il bersaglio è stato avvelenato.
(3) L'efficienza di sputtering di un gas di sputtering reattivo è intrinsecamente inferiore a quella di un gas inerte, quindi quando la proporzione di gas reattivo aumenta, la velocità di sputtering complessiva diminuisce.
Quinto, la soluzione per prendere di mira l'avvelenamento
(1) Utilizzare un alimentatore a frequenza intermedia o un alimentatore a radiofrequenza.
(2) Viene adottato un controllo a circuito chiuso dell'afflusso del gas di reazione.
(3) Utilizzo di bersagli gemelli
(4) Controllare il cambio della modalità di rivestimento: Prima
Rivestimento , raccogliere la curva dell'effetto di isteresi dell'avvelenamento target, in modo che il flusso d'aria di aspirazione sia controllato nella parte anteriore dell'avvelenamento target, in modo da garantire che il processo sia sempre in modalità prima che il tasso di deposizione diminuisca drasticamente.





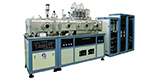

 spagnolo
spagnolo portoghese
portoghese